News und Artikel durchsuchen
{{#data.error.root_cause}}
{{/data.error}}
{{^data.error}}
{{#texts.summary}}
[{{{type}}}] {{{reason}}}
{{/data.error.root_cause}}{{texts.summary}} {{#options.result.rssIcon}} RSS {{/options.result.rssIcon}}
{{/texts.summary}} {{#data.hits.hits}}
{{#_source.featured}}
FEATURED
{{/_source.featured}}
{{#_source.showImage}}
{{#_source.image}}
{{/_source.image}}
{{/_source.showImage}}
{{/data.hits.hits}}
{{{_source.title}}} {{#_source.showPrice}} {{{_source.displayPrice}}} {{/_source.showPrice}}
{{#_source.showLink}} {{/_source.showLink}} {{#_source.showDate}}{{{_source.displayDate}}}
{{/_source.showDate}}{{{_source.description}}}
{{#_source.additionalInfo}}{{#_source.additionalFields}} {{#title}} {{{label}}}: {{{title}}} {{/title}} {{/_source.additionalFields}}
{{/_source.additionalInfo}}
FOVEROS
-
Packaging in Malaysia: Intel stellt Komplex fertig und verdoppelt Kapazitäten
 Intel-CEO Lip-Bu Tan hat sich bei seinem Besuch in Malaysia – wie für solche Besuche üblich – mit dem Premierminister Anwar Ibrahim getroffen und gemeinsam haben diese verkündet, dass der nun schon Jahre im Bau befindliche Komplex "Pelican" fertiggestellt werde. Intel betreibt in Malaysia, genauer auf der Halbinsel Penang, einige Fabrik-Komplexe, die einen großen Anteil an Intels Packaging-Kapazitäten darstellen. Bei unserem... [mehr]
Intel-CEO Lip-Bu Tan hat sich bei seinem Besuch in Malaysia – wie für solche Besuche üblich – mit dem Premierminister Anwar Ibrahim getroffen und gemeinsam haben diese verkündet, dass der nun schon Jahre im Bau befindliche Komplex "Pelican" fertiggestellt werde. Intel betreibt in Malaysia, genauer auf der Halbinsel Penang, einige Fabrik-Komplexe, die einen großen Anteil an Intels Packaging-Kapazitäten darstellen. Bei unserem... [mehr] -
Cougar Cove, Darkmont, Xe3-GPU und mehr: Intel nennt erste Details zu Panther Lake
 Mit Panther Lake wird Intel im kommenden Jahr eine weitere Core-Generation für Notebooks auf den Markt bringen. Vermutlich werden diese als Core-Ultra-300-Serie auf den Markt kommen, zum aktuellen Zeitpunkt aber spricht Intel noch nicht über solch einzelnen Produktdetails, sondern hat im Rahmen der diesjährigen Intel Tech Tour über den Aufbau und die architektonischen Details von Panther Lake gesprochen. Auf eben diese wollen wir in diesem... [mehr]
Mit Panther Lake wird Intel im kommenden Jahr eine weitere Core-Generation für Notebooks auf den Markt bringen. Vermutlich werden diese als Core-Ultra-300-Serie auf den Markt kommen, zum aktuellen Zeitpunkt aber spricht Intel noch nicht über solch einzelnen Produktdetails, sondern hat im Rahmen der diesjährigen Intel Tech Tour über den Aufbau und die architektonischen Details von Panther Lake gesprochen. Auf eben diese wollen wir in diesem... [mehr] -
PowerVia, RibbonFET und Foveros: Intel 18A für Panther Lake und Clearwater Forest
 Für die kommenden Notebook-Prozessoren alias Panther Lake und die Server-Prozessoren mit Efficiency-Kernen alias Clearwater Forest bringt Intel seine aktuell laut eigener Aussage fortschrittlichste Chipfertigung zum Einsatz. Mit Intel 18A will der Chipriese wieder zur alter Stärke zurückkehren, wenn es um die Chipfertigung geht. Alle Details zu Panther Lake und Clearwater Forest präsentieren wir in den jeweiligen Artikeln. Auf das, was... [mehr]
Für die kommenden Notebook-Prozessoren alias Panther Lake und die Server-Prozessoren mit Efficiency-Kernen alias Clearwater Forest bringt Intel seine aktuell laut eigener Aussage fortschrittlichste Chipfertigung zum Einsatz. Mit Intel 18A will der Chipriese wieder zur alter Stärke zurückkehren, wenn es um die Chipfertigung geht. Alle Details zu Panther Lake und Clearwater Forest präsentieren wir in den jeweiligen Artikeln. Auf das, was... [mehr] -
EMIB-T und Foveros-R/B: Intels neue Packaging-Optionen
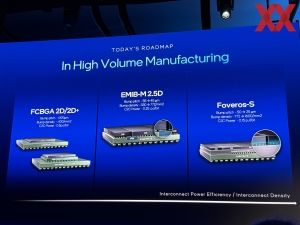 Neben der generellen Ausrichtung des Foundry-Geschäfts und den Details zu Intel 18A-P, Intel 18A-PT und ersten Informationen zu Intel 14A ist das (Advanced) Packaging das zweite Standbein für Intel. Auf der Direct-Connect-Konferenz gab es die Ankündigung zu einer neue EMIB- und zwei neuen Foveros-Varianten. Dass das Packaging für die Foundry-Sparte von enormer Bedeutung ist, ließ Intel erst vor wenigen Wochen erneut verlauten. Insofern... [mehr]
Neben der generellen Ausrichtung des Foundry-Geschäfts und den Details zu Intel 18A-P, Intel 18A-PT und ersten Informationen zu Intel 14A ist das (Advanced) Packaging das zweite Standbein für Intel. Auf der Direct-Connect-Konferenz gab es die Ankündigung zu einer neue EMIB- und zwei neuen Foveros-Varianten. Dass das Packaging für die Foundry-Sparte von enormer Bedeutung ist, ließ Intel erst vor wenigen Wochen erneut verlauten. Insofern... [mehr] -
Intel wittert seine Chance: Intel Foundry stellt das Advanced Packaging erneut ins Schaufenster
 Im Vorfeld der Direct Connect 2025 Ende April und der Vision 2025 in wenigen Tagen, auf der Lip-Bu Tan als neuer CEO erstmals eine Keynote abhalten wird, hat Intel erneut seine Bereitschaft bekräftigt für externe Kunden ein Advanced System Assembly & Test übernehmen zu können. Das Foundry-Segment von Intel wird seit Monaten und Jahren nicht müde immer wieder darauf zu verweisen, dass man offen für externe Kunden sei. Die Auftrennung in Intel... [mehr]
Im Vorfeld der Direct Connect 2025 Ende April und der Vision 2025 in wenigen Tagen, auf der Lip-Bu Tan als neuer CEO erstmals eine Keynote abhalten wird, hat Intel erneut seine Bereitschaft bekräftigt für externe Kunden ein Advanced System Assembly & Test übernehmen zu können. Das Foundry-Segment von Intel wird seit Monaten und Jahren nicht müde immer wieder darauf zu verweisen, dass man offen für externe Kunden sei. Die Auftrennung in Intel... [mehr] -
Nicht für Desktop-CPUs, aber ...: Clearwater Forest verwendet Cache im Base-Tile
 Gestern Abend saß Florian Maislinger, Tech Communications Manager bei Intel, bei der8auer und Bens Hardware im Stream und beantwortete dort Fragen zu den aktuellen Produkten – darunter natürlich vor allem zu Arrow Lake. Aus dem Chat kam hier die Frage, die auch wir bereits häufiger an Intel gestellt haben: AMD hat bewiesen, dass die Ryzen-Prozessoren mit 3D V-Cache einen deutlichen Vorteil in Spielen haben. Der Ryzen 7 5800X3D kam im... [mehr]
Gestern Abend saß Florian Maislinger, Tech Communications Manager bei Intel, bei der8auer und Bens Hardware im Stream und beantwortete dort Fragen zu den aktuellen Produkten – darunter natürlich vor allem zu Arrow Lake. Aus dem Chat kam hier die Frage, die auch wir bereits häufiger an Intel gestellt haben: AMD hat bewiesen, dass die Ryzen-Prozessoren mit 3D V-Cache einen deutlichen Vorteil in Spielen haben. Der Ryzen 7 5800X3D kam im... [mehr] -
Clearwater Forest: Intel setzt auf Intel 18A, Foveros Direct 3D und EMIB 3.5D
 Clearwater Forest soll mit seinen Efficiency-Kernen nicht nur aus Produktsicht ein herausragendes Produkt werden, sondern auch aus technischer Sicht. Bisher hat Intel in zahlreichen Gelegenheiten immer mal wieder einige kleine technische Details zu Clearwater Forest verkündet – so zum Beispiel die Fertigung in Intel 18A. Ein von Intel veröffentlichtes Dokument (PDF), welches schon den Namen Clearwater Forest trägt, sonst aber eher... [mehr]
Clearwater Forest soll mit seinen Efficiency-Kernen nicht nur aus Produktsicht ein herausragendes Produkt werden, sondern auch aus technischer Sicht. Bisher hat Intel in zahlreichen Gelegenheiten immer mal wieder einige kleine technische Details zu Clearwater Forest verkündet – so zum Beispiel die Fertigung in Intel 18A. Ein von Intel veröffentlichtes Dokument (PDF), welches schon den Namen Clearwater Forest trägt, sonst aber eher... [mehr] -
Multi-Chip-Packages: Intel über Glassubstrate, Die-Testing und Package-Fertigung
 Bereits vielfach hatten wir darüber berichtet, dass nahezu alle Halbleiterhersteller einerseits die Entwicklung immer weiter optimierter Fertigungsgrößen mit immer feineren Strukturen vorantreiben und andererseits auch das Packaging zu einem immer wichtigeren Faktor wird. Die Chipentwicklung selbst bewegt sich immer an der Grenze des aktuell möglichen. Das Packaging eröffnet neue Möglichkeiten – sei es das Zusammenführen mehrere Compute-Chips... [mehr]
Bereits vielfach hatten wir darüber berichtet, dass nahezu alle Halbleiterhersteller einerseits die Entwicklung immer weiter optimierter Fertigungsgrößen mit immer feineren Strukturen vorantreiben und andererseits auch das Packaging zu einem immer wichtigeren Faktor wird. Die Chipentwicklung selbst bewegt sich immer an der Grenze des aktuell möglichen. Das Packaging eröffnet neue Möglichkeiten – sei es das Zusammenführen mehrere Compute-Chips... [mehr] -
Intel auf dem IEDM 2022: Ausblick auf zukünftige Packaging- und Fertigunstechniken
 Auf dem IEEE IEDM (International Electron Devices Meeting) wird Intel gleich mehrere Forschungspapiere vorstellen. Einige Details dazu hat man nun bereits im Vorfeld veröffentlicht, denn das eigentliche Meeting findet erst in der kommenden Woche statt. Intel befindet sich aktuell in einer großen Umstrukturierungsphase hinsichtlich seiner Fertigungstechnologien. Aktuelle Produkte werden in Intel 7 gefertigt, was eine 10-nm-Fertigung in etlichen... [mehr]
Auf dem IEEE IEDM (International Electron Devices Meeting) wird Intel gleich mehrere Forschungspapiere vorstellen. Einige Details dazu hat man nun bereits im Vorfeld veröffentlicht, denn das eigentliche Meeting findet erst in der kommenden Woche statt. Intel befindet sich aktuell in einer großen Umstrukturierungsphase hinsichtlich seiner Fertigungstechnologien. Aktuelle Produkte werden in Intel 7 gefertigt, was eine 10-nm-Fertigung in etlichen... [mehr] -
Aus 10 werden 7 nm: Intel benennt Fertigungsgrößen neu und gibt Vorschau auf die nächsten Jahre
 Im Rahmen eines "Intel Accelerated" getauften Webcasts hat Intel am Abend über seine Pläne bei den Prozess- und Packaging-Roadmaps gesprochen. CEO Pat Gelsinger und Dr. Ann Kelleher, SVP und GM des Technology Development, haben noch einmal die grundsätzliche Neuausrichtung der IDM-2.0-Strategie aufgezeigt. Demnach wird Intel einerseits weiterhin (und eventuell auch im größeren Maßstab) die externe Fertigung von TSMC,... [mehr]
Im Rahmen eines "Intel Accelerated" getauften Webcasts hat Intel am Abend über seine Pläne bei den Prozess- und Packaging-Roadmaps gesprochen. CEO Pat Gelsinger und Dr. Ann Kelleher, SVP und GM des Technology Development, haben noch einmal die grundsätzliche Neuausrichtung der IDM-2.0-Strategie aufgezeigt. Demnach wird Intel einerseits weiterhin (und eventuell auch im größeren Maßstab) die externe Fertigung von TSMC,... [mehr] -
Intel: Tick-Tock is back und TSMC-Wafer mit Foveros und EMIB kombinierbar
 Nicht nur AMD nahm an der 49. JPMorgan-Konferenz teil (und sprach dabei über Genoa und CDNA 2), auch Intel nutzte die Bühne für einige interessante Details. Dabei wiederholte Intel einige der Ansätze, die im Rahmen der IDM-2.0-Ankündigung bereits eine Rolle spielten. So will Intel in seinen eigenen Möglichkeiten flexibler werden, aber auch seinen Kunden als Fertiger mehr Möglichkeiten bieten. So ist bereits bekannt, dass Intel für... [mehr]
Nicht nur AMD nahm an der 49. JPMorgan-Konferenz teil (und sprach dabei über Genoa und CDNA 2), auch Intel nutzte die Bühne für einige interessante Details. Dabei wiederholte Intel einige der Ansätze, die im Rahmen der IDM-2.0-Ankündigung bereits eine Rolle spielten. So will Intel in seinen eigenen Möglichkeiten flexibler werden, aber auch seinen Kunden als Fertiger mehr Möglichkeiten bieten. So ist bereits bekannt, dass Intel für... [mehr] -
Intels Zukunft liegt im Packaging und Chiplet-Design
 Der Intel Architecture Day 2020 hatte zahlreiche Neuheiten zu verkünden. Dazu gehören die Tiger-Lake-Prozessoren, Intels Rettungsaktion für die Fertigung in 10 nm, die Ankündigung einer Xe-HPG Gaming-GPU und vieles mehr. Doch auch wenn die Fertigung in 10 nm erst jetzt in Fahrt kommen wird und man erst kürzlich verkünden musste, dass sich die ersten Chips aus der Fertigung in 7 nm um sechs Monate verzögern werden, so hat man bei Intel... [mehr]
Der Intel Architecture Day 2020 hatte zahlreiche Neuheiten zu verkünden. Dazu gehören die Tiger-Lake-Prozessoren, Intels Rettungsaktion für die Fertigung in 10 nm, die Ankündigung einer Xe-HPG Gaming-GPU und vieles mehr. Doch auch wenn die Fertigung in 10 nm erst jetzt in Fahrt kommen wird und man erst kürzlich verkünden musste, dass sich die ersten Chips aus der Fertigung in 7 nm um sechs Monate verzögern werden, so hat man bei Intel... [mehr] -
Samsung zeigt 3D-Packaging-Technologie eXtended-Cube "X-Cube"
 Mit dem eXtended-Cube oder "X-Cube" hat Samsung eine neue 3D-Packaging-Technologie und somit das Gegenstück zu Intels Foveros-Technik vorgestellt. Erst gestern veröffentlichte Intel die zukünftigen Pläne in der 3D-Stacking-Technik und hat bereits im zweiten Quartal 2020 einen Chip mit Hybrid-Bonding-Technologie gefertigt. Dazu werden wir noch eine gesonderte Meldung veröffentlichen. eXtended-Cube wird dort zum Einsatz kommen, wo... [mehr]
Mit dem eXtended-Cube oder "X-Cube" hat Samsung eine neue 3D-Packaging-Technologie und somit das Gegenstück zu Intels Foveros-Technik vorgestellt. Erst gestern veröffentlichte Intel die zukünftigen Pläne in der 3D-Stacking-Technik und hat bereits im zweiten Quartal 2020 einen Chip mit Hybrid-Bonding-Technologie gefertigt. Dazu werden wir noch eine gesonderte Meldung veröffentlichen. eXtended-Cube wird dort zum Einsatz kommen, wo... [mehr] -
Lakefield im Test: Core i5-L16G7 mit fünf Kernen muss zeigen was er kann
 Vor einigen Wochen stellte Intel seine beiden Lakefield-Prozessoren vor – heute können wir einen Blick auf die Leistung werfen, denn mit dem Galaxy Book S von Samsung stand uns das erste Notebook zur Verfügung, welches ein Hybrid-Design aus dem Hause Intel verwendet. Neue Leistungsrekorde sind hier natürlich nicht zu erwarten, was aber von einem passiv gekühlten Sandwitch-Packaging zu erwarten ist, schauen wir uns auf den folgenden Seiten... [mehr]
Vor einigen Wochen stellte Intel seine beiden Lakefield-Prozessoren vor – heute können wir einen Blick auf die Leistung werfen, denn mit dem Galaxy Book S von Samsung stand uns das erste Notebook zur Verfügung, welches ein Hybrid-Design aus dem Hause Intel verwendet. Neue Leistungsrekorde sind hier natürlich nicht zu erwarten, was aber von einem passiv gekühlten Sandwitch-Packaging zu erwarten ist, schauen wir uns auf den folgenden Seiten... [mehr] -
Intel nennt erste technische Details zu den Lakefield-Prozessoren (Update)
 Bereits seit einigen Monaten spricht Intel mehr oder weniger nebulös über die neuen Lakefield-Prozessoren. Dabei handelt es sich um einen Hybrid-Prozessor, der aus einem einem großen Sunny-Cove-Kern und den vier Tremont-Kernen besteht. Das Hyperthreading ist sowohl auf dem Sunny-Cove-Kern als auch in den vier Tremont-Kernen nicht aktiv. Dem Sunny-Cove-Kern wurde zudem seine AVX512-Funktionalität genommen, um eine gewisse... [mehr]
Bereits seit einigen Monaten spricht Intel mehr oder weniger nebulös über die neuen Lakefield-Prozessoren. Dabei handelt es sich um einen Hybrid-Prozessor, der aus einem einem großen Sunny-Cove-Kern und den vier Tremont-Kernen besteht. Das Hyperthreading ist sowohl auf dem Sunny-Cove-Kern als auch in den vier Tremont-Kernen nicht aktiv. Dem Sunny-Cove-Kern wurde zudem seine AVX512-Funktionalität genommen, um eine gewisse... [mehr] -
Neue Details zu Lakefield, dem Foveros Die Interface und dem was danach kommt
 Gegenüber WikiChip hat Intel einige weitere Details zum Lakefield-Prozessor genannt, welcher der erste sein wird, der im 3D-Stacking das Foveros-Packaging in einen Prozessor bringt. Zuletzt tauchte ein niedrig aufgelöster Die-Shot des Compute-Dies auf und erste Benchmarks zeigen eine hohe Single-Threaded-Leistung. Bei WikiChip wird nun etwas ausführlicher über den Aufbau des Prozessors gesprochen. So wird der Base-Die in 22FFL gefertigt. Was... [mehr]
Gegenüber WikiChip hat Intel einige weitere Details zum Lakefield-Prozessor genannt, welcher der erste sein wird, der im 3D-Stacking das Foveros-Packaging in einen Prozessor bringt. Zuletzt tauchte ein niedrig aufgelöster Die-Shot des Compute-Dies auf und erste Benchmarks zeigen eine hohe Single-Threaded-Leistung. Bei WikiChip wird nun etwas ausführlicher über den Aufbau des Prozessors gesprochen. So wird der Base-Die in 22FFL gefertigt. Was... [mehr] -
Silizium im Fokus: Intel zeigt einen Lakefield-Prozessor
 Intel möchte offenbar die Lakefield-Prozessoren noch einmal in den Fokus rücken und zeigt den Chip hinter einem Vergrößerungsglas – gehalten von Intel Fellow Wilfred Gomes, einem Mitglied der Silicon Engineering Group, die den Lakefield-Prozessor bzw. die Fertigung dazu entwickelt hat. Highlight des Lakefield-Prozessors ist das hybride Design bestehend aus einem großen Sunny-Cove-Kern, der in 10 nm gefertigt wird, sowie... [mehr]
Intel möchte offenbar die Lakefield-Prozessoren noch einmal in den Fokus rücken und zeigt den Chip hinter einem Vergrößerungsglas – gehalten von Intel Fellow Wilfred Gomes, einem Mitglied der Silicon Engineering Group, die den Lakefield-Prozessor bzw. die Fertigung dazu entwickelt hat. Highlight des Lakefield-Prozessors ist das hybride Design bestehend aus einem großen Sunny-Cove-Kern, der in 10 nm gefertigt wird, sowie... [mehr] -
7 nm, Foveros und CXL: Intel präsentiert "Ponte Vecchio" Xe-GPU für das Datacenter
 Zur Supercomputing 2019 stellt Intel seine groben Hardwarestrukturen für 2021 vor. Sowohl im Bereich der Prozessoren, als auch bei den General Purpose GPUs gibt es neue Details zu berichten. Aber wie gesagt, wir sprechen hier von 2021, also bis wir konkrete Hardware sehen, wird es noch mehr als 12 Monate dauern. Für Endkunden bleiben damit viele Fragen offen. Auf Seiten der Xeon-Prozessoren nennt Intel den bereits bekannten Zeitplan. 2020... [mehr]
Zur Supercomputing 2019 stellt Intel seine groben Hardwarestrukturen für 2021 vor. Sowohl im Bereich der Prozessoren, als auch bei den General Purpose GPUs gibt es neue Details zu berichten. Aber wie gesagt, wir sprechen hier von 2021, also bis wir konkrete Hardware sehen, wird es noch mehr als 12 Monate dauern. Für Endkunden bleiben damit viele Fragen offen. Auf Seiten der Xeon-Prozessoren nennt Intel den bereits bekannten Zeitplan. 2020... [mehr] -
Intel: Co-EMIB kombiniert EMIB und FOVEROS in riesigen Packages
 Auf der SemiCon West hat Intel über neue Packaging-Technologien gesprochen. Zuletzt machte der Chipgigant mit der Nennung einiger neuer Daten zu FOVEROS auf sich aufmerksam. Co-EMIB soll die beiden bestehenden Packaging-Technologien für Intel zusammenführen. Während EMIB (Embedded Multi Die Interconnect Bridge) bereits bei den Kaby-Lake-G-Prozessoren sowie den Stratix-10-FPGAs zum Einsatz kommt, wird FOVEROS bisher nur bei den noch... [mehr]
Auf der SemiCon West hat Intel über neue Packaging-Technologien gesprochen. Zuletzt machte der Chipgigant mit der Nennung einiger neuer Daten zu FOVEROS auf sich aufmerksam. Co-EMIB soll die beiden bestehenden Packaging-Technologien für Intel zusammenführen. Während EMIB (Embedded Multi Die Interconnect Bridge) bereits bei den Kaby-Lake-G-Prozessoren sowie den Stratix-10-FPGAs zum Einsatz kommt, wird FOVEROS bisher nur bei den noch... [mehr] -
Intel nennt technische Details zur FOVEROS-Fertigung
 Vor einigen Tagen präsentierte TSMC sein Konzept bzw. einen ersten Prototypen für ein Chiplet-Design für ARM-HPC-Prozessoren. Damit möchte TSMC natürlich die eigenen Technologien wie die Chip-on-Wafer-on-Substrate (CoWoS) Packaging-Technologie oder den Low-voltage-In-Package-Interconnect (LIPINCON) präsentieren. Die von TSMC veröffentlichten Zahlen ermöglichen aber vor allem einen Vergleich der unterschiedlichen Fertigungs-... [mehr]
Vor einigen Tagen präsentierte TSMC sein Konzept bzw. einen ersten Prototypen für ein Chiplet-Design für ARM-HPC-Prozessoren. Damit möchte TSMC natürlich die eigenen Technologien wie die Chip-on-Wafer-on-Substrate (CoWoS) Packaging-Technologie oder den Low-voltage-In-Package-Interconnect (LIPINCON) präsentieren. Die von TSMC veröffentlichten Zahlen ermöglichen aber vor allem einen Vergleich der unterschiedlichen Fertigungs-... [mehr] -
Intel erläutert Foveros und Lakefield-CPU im Video
 Anfang Dezember führte Intel erstmals seinen neuen 10-nm-SoC Lakefield genauer aus. Nun hat man ein Video zur Kombination aus Lakefield-SoC unter der Verwendung der Foveros-Technologie veröffentlicht, welches die Komponenten und Funktionsweise der Technik etwas erläutert. Die Lakefield-Prozessoren werden vermutlich zu den ersten Produkten auf Basis der Foveros-Stapeltechnik gehören, die das Licht der Welt erblicken. Bisher gibt es noch... [mehr]
Anfang Dezember führte Intel erstmals seinen neuen 10-nm-SoC Lakefield genauer aus. Nun hat man ein Video zur Kombination aus Lakefield-SoC unter der Verwendung der Foveros-Technologie veröffentlicht, welches die Komponenten und Funktionsweise der Technik etwas erläutert. Die Lakefield-Prozessoren werden vermutlich zu den ersten Produkten auf Basis der Foveros-Stapeltechnik gehören, die das Licht der Welt erblicken. Bisher gibt es noch... [mehr] -
Foveros führt Intel in die Multi-Chip-Zukunft
 Über Jahre hinweg hilt Intel an einem monolithischen Aufbau der Prozessoren fest. Für Spezialanwendungen wurden bereits FPGAs oder GPUs im Package per EMIB oder einer anderen Interposer-Technologie angebunden, aber zumindest mit der Ankündigung die Cascade-Lake-AP-Prozessoren bestünden aus zwei CPU-Dies mit jeweils 24 Kernen war klar, dass auch bei Intel ein Umdenken in der allgemeinen Strategie begonnen hat. Die Konkurrenz macht es vor, was... [mehr]
Über Jahre hinweg hilt Intel an einem monolithischen Aufbau der Prozessoren fest. Für Spezialanwendungen wurden bereits FPGAs oder GPUs im Package per EMIB oder einer anderen Interposer-Technologie angebunden, aber zumindest mit der Ankündigung die Cascade-Lake-AP-Prozessoren bestünden aus zwei CPU-Dies mit jeweils 24 Kernen war klar, dass auch bei Intel ein Umdenken in der allgemeinen Strategie begonnen hat. Die Konkurrenz macht es vor, was... [mehr]
